Chip- und Drahtbonden
Mikromontage mit verschiedenen Technologien und Materialien in eigener Produktion: Chip on Board (CoB) auf verschiedenen Trägern wie Chip-on-Glass, Chip-on-Ceramic und Chip-on-Flex
Unser qualifiziertes Fachpersonal arbeitet im Reinraum nach den IPC-Vorgaben. Mit modernster Technik produzieren wir feinste Verbindungen. Integrierte Schaltkreise oder diskrete Halbleiter werden durch Drahtbonden mit elektrischen Anschlüssen anderer Bauteile oder Gehäuse verbunden.
Beim Chipbonden wird der Wafer durch Kleben mit der Grundplatte verbunden.
Kontaktieren Sie unsere Anwendungsexperten

Unsere Technologien zur Chip-Montage
- Chip Montage von Halbleiterchips, LED, MMIC (Monolithic Microwave Integrated Circuit) mit Klebstoffen, Sintermaterialien
- Lötmaterialien auf starren und flexiblen Substraten
- Nacktchipmontage / CoB (Chip-on-Board Technology)
- CoG (Chip-on-Glas), CoX (Chip-on-Flex), (Chip-on-Ceramic)
- MEMS (microelectromechanical systems) Chips (IR Emitter, Thermopile, pyroelektrische Chips, ...)
- Verarbeitung von Optische Elemente (IR Filter, Linsen, ...)
- Spaltschweißen bei Verdrahtungen von Sensoren mit einer Leiterplatte
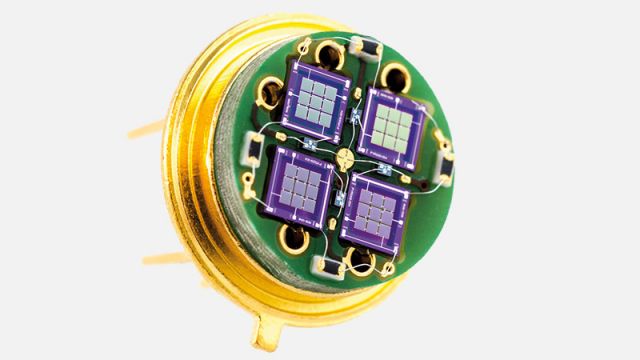
Chipbonden
Ungehauste Halbleiter-Chips (Bare-Dice) bieten viele Vorteile gegenüber herkömmlichen Elektronik-Komponenten wie zum Beispiel SMD-Bauteilen (Surface Mounted Devices). Beim Chipbonden werden die einzelnen Halbleiterchips eines Wafers mit Klebstoff auf einem Substrat fixiert. Wir arbeiten mit unterschiedlichen Technologien und Prozessen:
- Vollautomatische Zu- und Abfuhrsysteme beim Die-Bonden
- Die-Bonden / Chip-Bonden mit Aufnahme von Bauteilen / Chips aus Gurten oder Tabletts und computergesteuertem Platzieren, Eintauchen oder Dispensen
- Plasma-Oberflächenbehandlung von Halbleitermaterialien, optischen und strukturellen Elementen

Drahtbonden
Die Kontaktierung ungehäuster Halbleiter (Bare-Dice) erfolgt typischerweise per Drahtbonden (Wire Bonding). Diese visuell überprüfbare Kontaktierungsmöglichkeit wird häufig beim Packaging hochzuverlässiger Schaltungen eingesetzt.
- Vollautomatische Zu- und Abfuhrsysteme beim Die-Bonden
- Die-Bonden / Chip-Bonden mit Aufnahme von Bauteilen / Chips aus Gurten oder Tabletts und computergesteuertem Platzieren, Eintauchen oder Dispensen
- Plasma-Oberflächenbehandlung von Halbleitermaterialien, optischen und strukturellen Elementen
Wir beraten Sie gern zu Ihrem Entwicklungsprojekt und den optimalen Substrat- und Packagingtechnologien.
Direktkontakt zu Ansprechpartnern
Elektronische Mikro Systeme